En general, és difícil evitar una petita quantitat de fallades en el desenvolupament, la producció i l'ús de dispositius semiconductors. Amb la millora contínua dels requisits de qualitat del producte, l'anàlisi de fallades esdevé cada cop més important. Mitjançant l'anàlisi de xips de fallada específics, es pot ajudar els dissenyadors de circuits a trobar els defectes de disseny del dispositiu, la discrepància dels paràmetres del procés, el disseny irracional del circuit perifèric o el mal funcionament causat pel problema. La necessitat de l'anàlisi de fallades dels dispositius semiconductors es manifesta principalment en els aspectes següents:
(1) L'anàlisi de fallades és un mitjà necessari per determinar el mecanisme de fallada del xip del dispositiu;
(2) L'anàlisi de fallades proporciona la base i la informació necessàries per a un diagnòstic eficaç de fallades;
(3) L'anàlisi de fallades proporciona la informació de retroalimentació necessària perquè els enginyers de disseny puguin millorar o reparar contínuament el disseny del xip i fer-lo més raonable d'acord amb l'especificació del disseny;
(4) L'anàlisi de fallades pot proporcionar el suplement necessari per a les proves de producció i proporcionar la base d'informació necessària per a l'optimització del procés de prova de verificació.
Per a l'anàlisi de fallades de díodes semiconductors, audions o circuits integrats, primer s'han de comprovar els paràmetres elèctrics i, després de la inspecció de l'aspecte amb el microscopi òptic, s'ha de retirar l'embalatge. Mantenint la integritat de la funció del xip, s'han de mantenir els cables interns i externs, els punts d'unió i la superfície del xip el màxim possible, per tal de preparar-se per al següent pas d'anàlisi.
Utilitzant microscòpia electrònica de rastreig i espectre d'energia per fer aquesta anàlisi: incloent l'observació de la morfologia microscòpica, la cerca de punts de fallada, l'observació i la ubicació dels punts de defecte, la mesura precisa de la mida de la geometria microscòpica del dispositiu i la distribució del potencial de la superfície rugosa i el judici lògic del circuit de porta digital (amb mètode d'imatge de contrast de voltatge); Utilitzant un espectròmetre d'energia o un espectròmetre per fer aquesta anàlisi té: anàlisi de la composició d'elements microscòpics, anàlisi de l'estructura del material o de contaminants.
01. Defectes superficials i cremades de dispositius semiconductors
Els defectes superficials i la cremada dels dispositius semiconductors són modes de fallada comuns, com es mostra a la Figura 1, que és el defecte de la capa purificada del circuit integrat.

La figura 2 mostra el defecte superficial de la capa metal·litzada del circuit integrat.

La figura 3 mostra el canal de ruptura entre les dues tires metàl·liques del circuit integrat.

La figura 4 mostra el col·lapse de la tira metàl·lica i la deformació biaixada del pont d'aire del dispositiu de microones.

La figura 5 mostra la combustió de la reixeta del tub de microones.
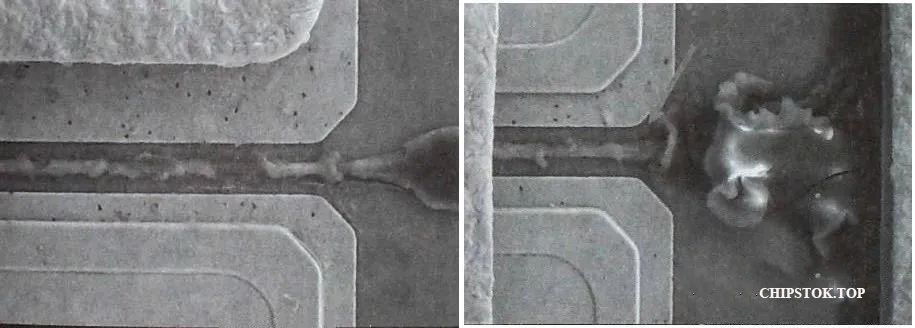
La figura 6 mostra el dany mecànic al cable metal·litzat elèctric integrat.
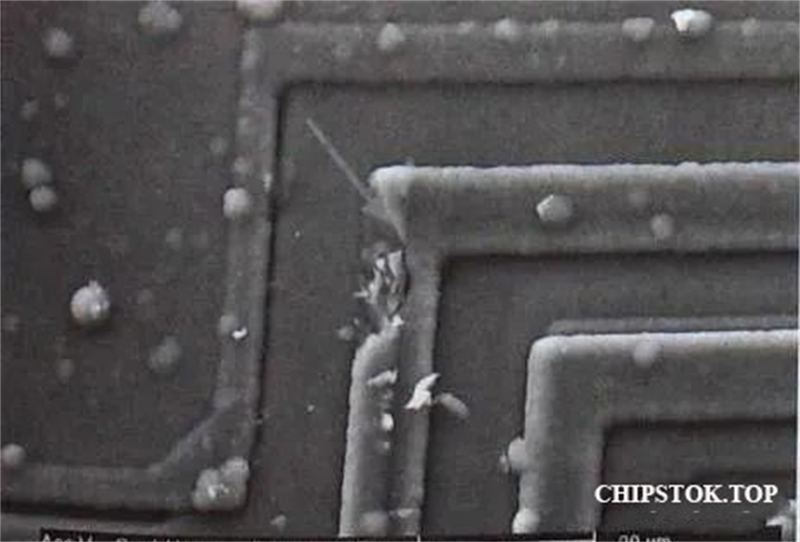
La figura 7 mostra l'obertura i el defecte del xip del díode mesa.

La figura 8 mostra la ruptura del díode de protecció a l'entrada del circuit integrat.

La figura 9 mostra que la superfície del xip del circuit integrat està danyada per impacte mecànic.

La figura 10 mostra la degradació parcial del xip del circuit integrat.

La figura 11 mostra que el xip del díode es va trencar i es va cremar greument, i els punts de ruptura van passar a un estat de fusió.
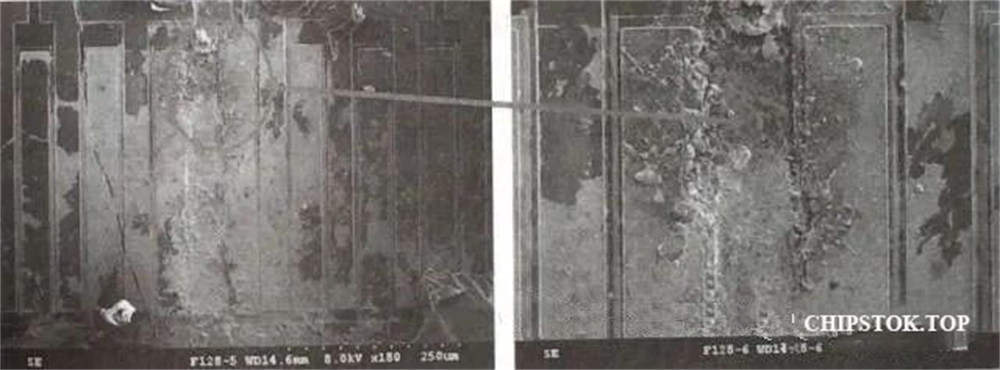
La figura 12 mostra el xip del tub de microones de nitrur de gal·li cremat, i el punt cremat presenta un estat de pulverització catòdica fos.
02. Avaria electrostàtica
Els dispositius semiconductors, des de la fabricació, l'embalatge i el transport fins a la inserció a la placa de circuit, la soldadura, el muntatge de màquines i altres processos, estan sota l'amenaça de l'electricitat estàtica. En aquest procés, el transport es veu afectat a causa del moviment freqüent i la fàcil exposició a l'electricitat estàtica generada pel món exterior. Per tant, cal prestar especial atenció a la protecció electrostàtica durant la transmissió i el transport per reduir les pèrdues.
En dispositius semiconductors amb tub MOS unipolar i circuit integrat MOS, els tubs MOS són particularment sensibles a l'electricitat estàtica, especialment els tubs MOS, a causa de la seva pròpia resistència d'entrada molt alta i la capacitat de l'elèctrode porta-font és molt petita, per la qual cosa és molt fàcil que es vegi afectat per un camp electromagnètic extern o inducció electrostàtica i es carregui, i a causa de la generació electrostàtica, és difícil descarregar la càrrega a temps. Per tant, és fàcil provocar l'acumulació d'electricitat estàtica fins a la ruptura instantània del dispositiu. La forma de ruptura electrostàtica és principalment una ruptura enginyosa elèctrica, és a dir, la fina capa d'òxid de la reixeta es trenca, formant un forat, que curtcircuita la bretxa entre la reixeta i la font o entre la reixeta i el dren.
I en relació amb el tub MOS, la capacitat de ruptura antiestàtica del circuit integrat MOS és relativament lleugerament millor, ja que el terminal d'entrada del circuit integrat MOS està equipat amb un díode de protecció. Quan hi ha una tensió electrostàtica o sobretensió elevada, la majoria dels díodes de protecció es poden connectar a terra, però si la tensió és massa alta o el corrent d'amplificació instantani és massa gran, de vegades els díodes de protecció s'activaran ells mateixos, com es mostra a la Figura 8.
Les diverses imatges que es mostren a la figura 13 mostren la topografia de ruptura electrostàtica d'un circuit integrat MOS. El punt de ruptura és petit i profund, presentant un estat de pulverització catòdica fosa.

La figura 14 mostra l'aspecte de la ruptura electrostàtica del capçal magnètic d'un disc dur d'ordinador.

Data de publicació: 08 de juliol de 2023







